
新闻资讯
让您第一时间了解我们的最新消息
5月20-23日,2025西门子大中华区 Simcenter 仿真与试验技术峰会在合肥圆满举行。本届峰会以“工程创新,智启未来”为主题,聚焦电子散热、电驱动系统、机电一体化、整车能量管理、人工智能与数字孪生、流动与传热等领域,汇聚国内外各行业专家、企业代表及科研精英,近距离了解西门子仿真与试验Simcenter 的最新开发和应用进展,并深度分享多位重磅嘉宾带来的前瞻性研究成果。

中恒微作为国内功率半导体行业重要推进者受邀出席峰会,并作《Simcenter 产品在新型分布式功率模块设计中的应用》主题演讲,展现强大研发实力,共话仿真试验技术。依托于功率器件研发领域多年的深耕与积累,中恒微创新性地推出新型分布式功率模块。产品采用超声波工艺焊接,增加了模块大电流运行下的可靠性并提升了使用寿命;PCB内置集成设计,使得芯片均流特性得到提升,主要适用于工业变频、光伏储能、汽车功率模块等大电流应用场景。

新型分布式功率模块DD600M120S1P
应用优势
实现多芯片并联热阻大幅降低
以ED3为例,传统封装的ED3 600A上下桥分别使用3并联200A,热耦合严重,温升高;分布式模块上下桥分别采用12并联50A芯片,芯片分布均匀,解决了热耦合问题,温升低。
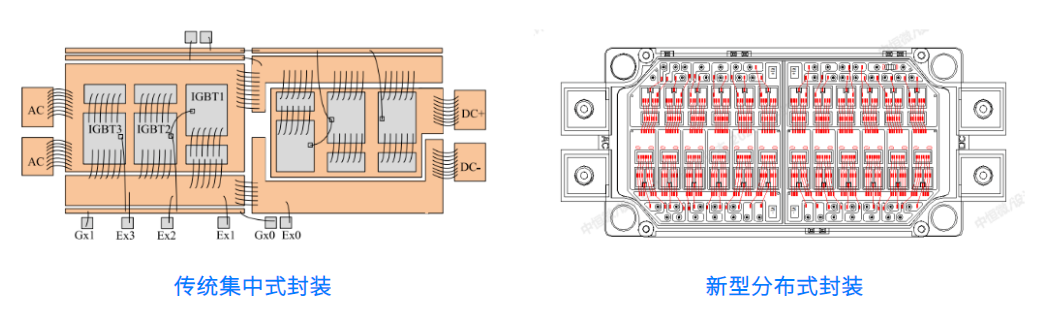
寄生电感仿真对比
ED3传统集中式封装:20nH
D1新型分布式封装:7nH
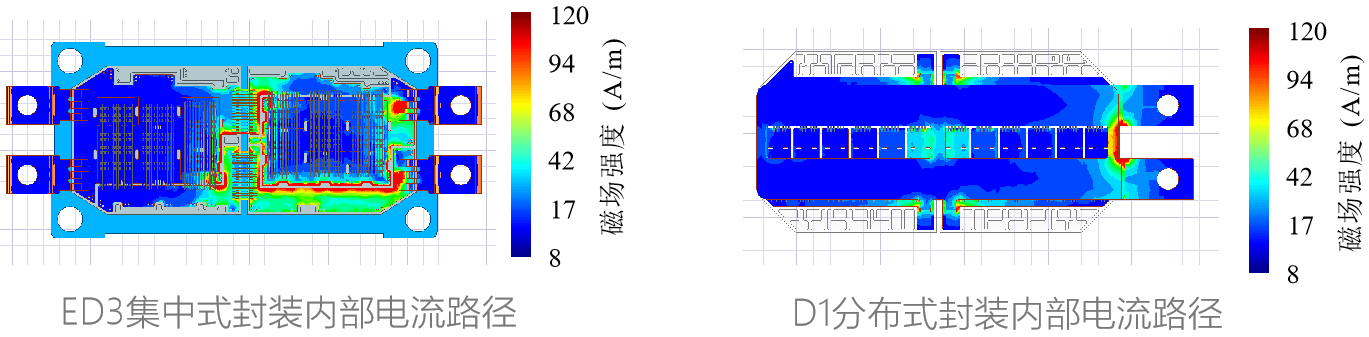
相较于传统封装,分布式模块杂感降低了65%
结温仿真对比
在热模型建立上采用均分原理,每个芯片均分总损耗,并且选择的材料热导率一样;通过Simcenter FloEFD 有限元仿真分析发现集中式的芯片的热耦合效应更明显,并且最大结温更高。
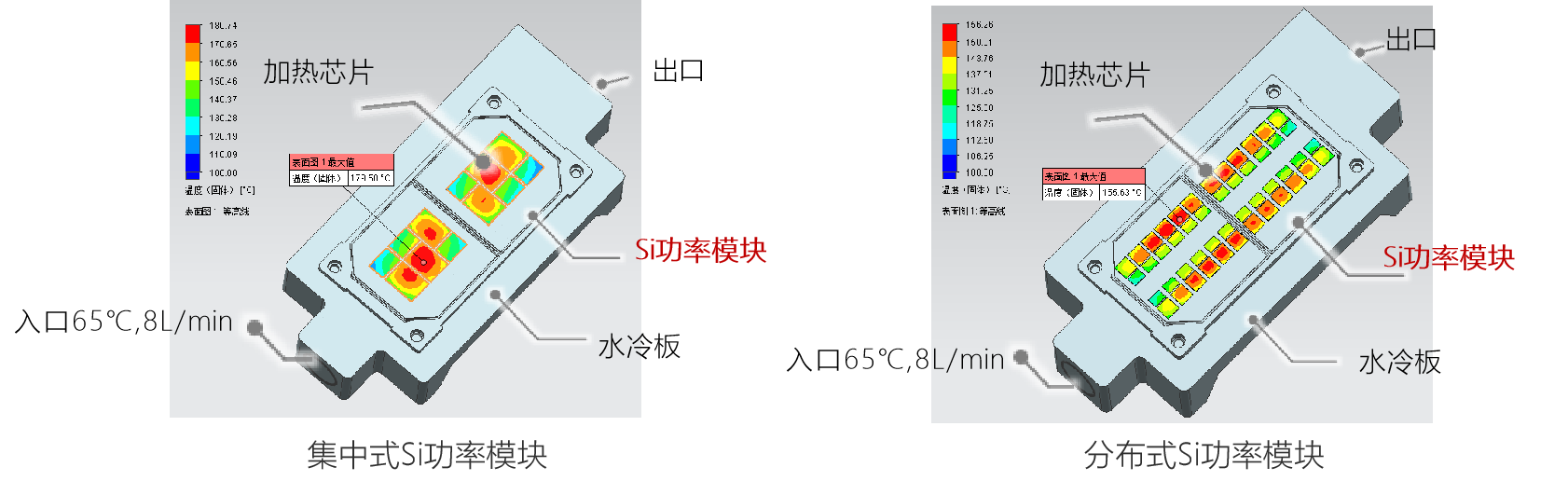
Simcenter FloEFD 有限元仿真分析结果

通过在Simcenter仿真平台的损耗计算和热仿真可以看出,分布式的芯片最大结温比集中式的低20~30℃,在热方案解决上有了质的飞跃,解决了大电流情况下模块的散热问题。采用多芯片并联,使得芯片开发成本降低,解决了IGBT热耦合严重的情况,相对于集中式,分布式提高了模块的使用寿命。分布式功率模块的电学性能显著优于集中式功率模块,现已优先推出ED3封装1200V,600A/800A/900A产品,未来将逐步推出更多型号产品,为高电流、高功率密度应用提供更优质更丰富的新型分布式解决方案。
产品特点
应用领域

上一篇:没有上一条了